ICM—以应用为导向的创新研究


文章导读
随着微电子技术的发展,半导体器件的特征尺寸不断缩小推动了光刻技术的持续进步,也对光刻胶的性能提出了更高要求。传统的化学放大光刻胶因其高灵敏度在产业界得到广泛应用,但当光刻图形的尺寸缩小至20 nm以下时,化学放大光刻胶中光致产酸剂的随机分布和酸扩散过程会导致光刻图案的线边缘粗糙度变差,不利于分辨率的进一步提高。非化学放大型光刻胶(n-CAR)可直接利用主体材料中光敏基团发生的光化学反应实现溶解度转变,避免了化学放大光刻胶中组分分布不均匀和酸扩散不可控等问题,具有形成高分辨率图案的优势。
近期,中国科学院理化技术研究所李嫕研究员、陈金平研究员,联合中国科学院化学研究所杨国强研究员和上海光源软X射线干涉光刻线站(BL08U1B) 报道了一类不同取代芳基磺酸酯修饰的聚苯乙烯 (X-SEPS, X = -H, -OCH3, -CN)非化学放大型光刻胶。通过电子束光刻详细研究了取代基团对光刻胶光刻性能的影响,结合理论计算和石英晶体微天平(QCM)对薄膜的溶解行为测试,表明键能变化不是影响光刻性能的主要因素,取代基团对光刻胶膜在显影液中的溶解行为差异是影响其光刻性能的关键因素之一。综合性能最佳的H-SEPS光刻胶在电子束光刻中实现了密集线条18 nm和半密集线条10 nm的光刻图案,极紫外光刻实现了密集线条22 nm光刻图案。
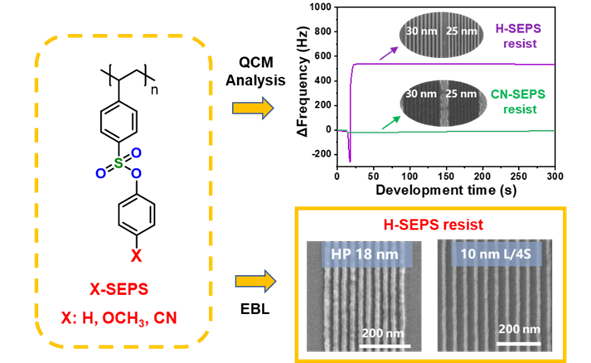
图文摘要:基于芳基磺酸酯修饰的聚苯乙烯衍生物非化学放大型光刻胶及光刻结果
上述成果发表在Industrial Chemistry & Materials,题为:Lithographic performances of aryl sulfonate ester-modified polystyrenes as nonchemically amplified resists。欢迎扫描下方二维码或者点击下方链接免费阅读、下载!
扫二维码|查看原文

https://doi.org/10.1039/D5IM00046G
本文亮点
★ 采用可逆加成-断裂链转移 (RAFT) 可控聚合方法合成了3种不同取代芳基磺酸酯修饰的聚苯乙烯衍生物,制备得到了3种非化学放大光刻胶;
★ 研究了3种光刻胶的电子束光刻性能,证明了取代基团主要通过影响光刻胶薄膜在显影液中的溶解行为来影响其光刻性能;
★ 综合性能最佳的H-SEPS光刻胶在电子束光刻中实现了密集线条18 nm和半密集线条10 nm的光刻图案,极紫外光刻实现了密集线条22 nm光刻图案;
★ 揭示了光刻胶的曝光机理,聚合物中磺酸酯基团在曝光后发生分解,生成极性的磺酸以及重排产物引起了光刻胶膜在显影液中的溶解度转变。
图文解读
1. 不同取代芳基磺酸酯修饰的聚苯乙烯衍生物(X-SEPS)的合成
以4-苯乙烯磺酸钠和对位取代X基团的苯酚为原料,高效制备得到不同取代芳基磺酸酯苯乙烯单体,通过RAFT聚合方法制备得到目标分子量的聚合物。凝胶色谱(GPC)测试结果表明聚合物的分子量(Mw)在5.7-7.1 kDa之间,分子量分布系数(PDI)在1.2以下。

图1. X-SEPS的合成示意图
2. 聚合物理化性质表征
热性质测试表明聚苯乙烯衍生物X-SEPS的分解温度均高于200 ℃,玻璃化转变温度为90-108 ℃,满足光刻胶主体材料对热稳定性的要求。使用原子力显微镜(AFM)表征了光刻胶膜的表面形貌,3种芳基磺酸酯修饰的聚苯乙烯衍生物材料在10×10 μm2的测量区域内表面粗糙度均为0.3 nm,表明此类光刻胶具有良好的成膜性能。

图2. X-SEPS聚合物的(a) TGA曲线,(b) DSC曲线和(c)膜表面AFM形貌图
3. X-SEPS光刻胶电子束光刻性能
以甲基异丁基酮(MIBK)为共同显影液,研究了3种光刻胶的电子束光刻性能。其中,H-SEPS与MeO-SEPS光刻胶均可实现HP 30、25和22 nm的条纹图案,但H-SEPS光刻胶形成的光刻条纹LER和LWR更小,22nm的密集图案的LER和LWR仅分别为2.7和4.3 nm,CN-SEPS光刻胶由于条纹之间的沟槽无法被显影干净而使得图案无法分辨。对比度曲线表明三种光刻胶对比度顺序为H-SEPS (γ = 4.1) > MeO-SEPS (3.2) > CN-SEPS (γ = 1.4),灵敏度为CN-SEPS (1196 μC) > H-SEPS (2264 μC) > MeO-SEPS (3276 μC)。3种光刻胶由于取代基团的不同,其光刻性能存在较大差异。键能是影响光刻胶灵敏度的重要因素,通常键能越低有利于断键,光刻胶灵敏度越高。理论计算表明三种光刻胶的ArO-S键能分为 291.5 (H-SEPS), 278.8 (MeO-SEPS)和294.8 kJ mol−1 (CN-SEPS),键能的大小和三种光刻胶的灵敏度顺序并不一致,表明键能大小不是影响光刻胶灵敏度的主要因素。石英晶体微天平(QCM) 测试了三种光刻胶膜在显影液中的溶解动力学,H-SEPS和MeO-SEPS光刻胶膜在显影液中迅速溶解,而CN-SEPS光刻胶膜在显影液中先发生溶胀,然后缓慢溶解,在测试时间480 s仍未溶解完全,说明其溶解速率慢,这和三种光刻胶的对比度和图案分辨结果一致。电子束光刻结果表明键能变化不是影响光刻性能的主要因素,取代基团对光刻胶膜在显影液中的溶解行为差异是影响其光刻性能的关键因素之一。
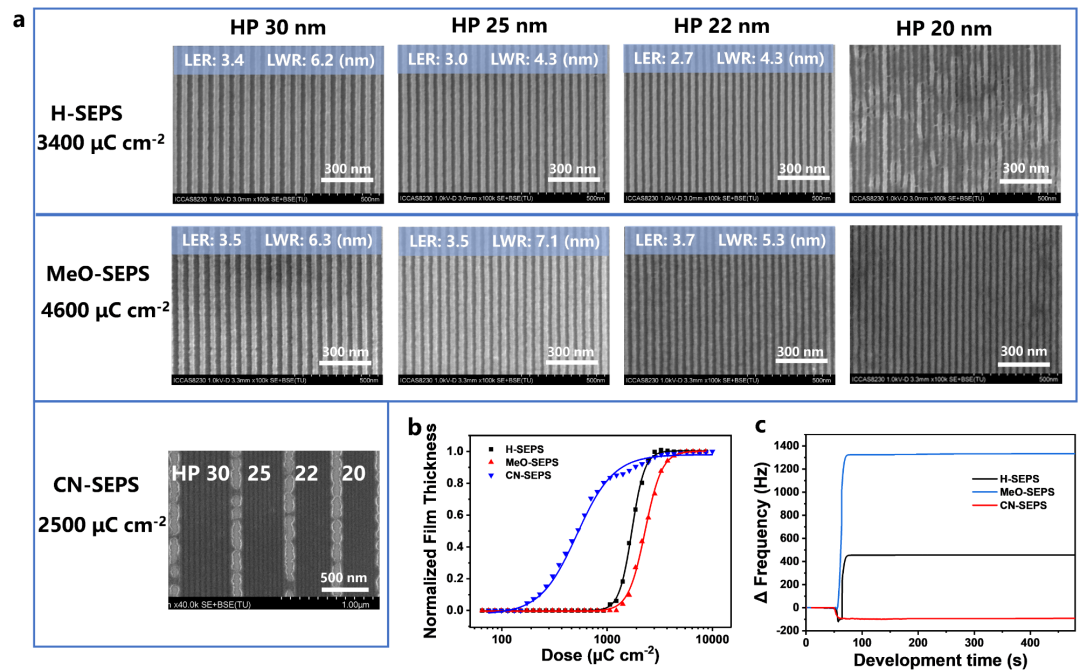
图3. (a)X-SEPS光刻胶电子束光刻图案的SEM图;(b)X-SEPS光刻胶的电子束光刻对比度曲线;(c)X-SEPS光刻胶薄膜在MIBK显影中溶解动力学性能
4. H-SEPS光刻胶电子束和极紫外光刻优化
对综合性能最优的H-SEPS光刻胶进行显影液优化,H-SEPS光刻胶在4种显影液中均可形成25 nm的密集线条图形,乙腈具有最佳显影效果,可在3200 μC cm-2剂量下实现最高分辨率为18 nm, LER为3.7 nm的图案。对于半密集线条图案,乙酸丁酯具有出最佳显影效果,在2800 μC- cm-2曝光剂量下,实现最小线宽为10 nm (Line/4 Space),LER为3.6 nm的光刻图案。以乙腈为显影液,对H-SEPS光刻胶进行极紫外光刻,可以实现无桥联和无倒塌的25和 22 nm 密集线条图形,证明H-SEPS光刻胶可用于极紫外光刻。受极紫外光刻光栅条件的限制,后续将进一步利用更小特种尺寸的光栅开展极紫外高分辨光刻研究。
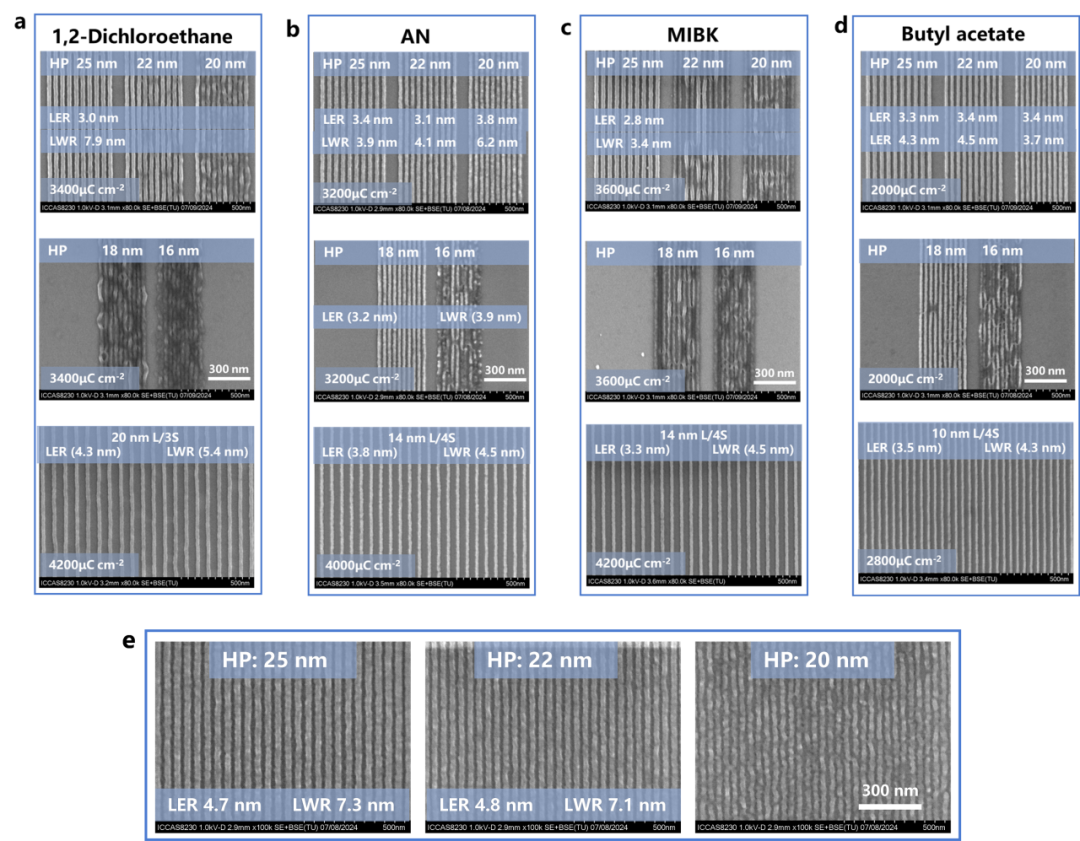
图4. (a-d) H-SEPS光刻胶不同显影液中的电子束光刻图案;(e) 极紫外光刻图案
5. X-SEPS光刻胶的光刻机理与抗刻蚀性
采用核磁氢谱、质谱、极紫外原位产气分析装置以及X-射线光电子能谱分析仪研究了H-SEPS光刻胶的曝光机理。结果表明H-SEPS光刻胶薄膜中芳基磺酸酯基团发生分解, ArO-S键的断裂是主要途径,Ar-OS键的断裂是次要途径。这两种途径都产生磺酸和少量重排化合物,其中少量的磺酸进一步分解生成气体碎片。芳基磺酸酯分解成极性的磺酸基团,伴随着少量的重排,导致光刻胶薄膜曝光后在显影液中产生溶解度的变化,形成负性光刻图案。
利用等离子低温刻蚀工艺对可形成高分辨电子束光刻图案的两种光刻胶H-SEPS和MeO-SEPS光刻胶进行干法刻蚀。H-SEPS光刻胶膜对硅的刻蚀选择比达到9.2:1,优于商用PMMA (950K) 光刻胶 (相同条件下抗刻蚀选择比为6)。同样的条件下测试得MeO-SEPS光刻胶的刻蚀选择比为8.8:1,与H-SEPS光刻胶相近。

图5. (a) H-SEPS光刻胶可能的极紫外光刻机理;(b) H-SEPS光刻胶的抗刻蚀性测试
总结与展望
本文设计并制备了三种基于芳基磺酸酯修饰的聚苯乙烯衍生物非化学放大光刻胶 (X - SEPS, X = H-, MeO-和CN-),3种光刻胶表现出完全不同的电子束光刻性能。QCM分析并结合键能理论计算证实取代基对光刻胶薄膜在显影剂中的溶解行为影响导致了不同的光刻性能。H-SEPS光刻胶分别在电子束和极紫外光刻中实现了18 nm和 22 nm的密集线条图形。机理研究表明,芳基磺酸酯分解为磺酸是导致光刻胶薄膜溶解性转换的主要原因。本研究表明基于芳基磺酸酯光敏基团的非化学放大光刻胶可以通过改变芳基取代基来实现高分辨光刻,取代基主要改变了光刻胶薄膜在显影液中的溶解行为,这为非化学放大光刻胶的设计和开发提供了有用的指导。
撰稿:原文作者
排版:ICM编辑部
文章信息
R. Peng, P. Lian, J. Chen, T. Yu, Y. Zeng, S. Wang, X. Guo, R. Hu, J. Zhao, Y. Wu, G. Yang and Y. Li, Lithographic performances of aryl sulfonate ester-modified polystyrenes as nonchemically amplified resists, Ind. Chem. Mater., 2025, DOI: 10.1039/D5IM00046G.
作者简介

通讯作者
李嫕,1985年北京大学化学系获理学学士学位;1988年北京理工大学获工学硕士学位;1994年中国科学院感光所获理学博士学位。1996-1999年,在美国依利诺伊大学厄巴拿-香槟分校(UIUC)从事博士后研究工作。1999年入选中国科学院人才计划,结题评为优秀。现任理化所研究员,国科大教授,教研室主任;中国感光学会光刻材料与技术专业委员会副主任,中国化学会光化学专业委员会和女化学工作者委员会委员;先后主持承担多项中国科学院、财政部(仪器研制)、科技部、基金委重大\重点项目和课题、国家重大科技专项(02专项)等。在光功能材料设计和材料光物理过程等方面开展研究工作,已发表学术论文200余篇,申请中国发明专利101项(授权61项)。

通讯作者
杨国强,1985年北京大学化学系获学士学位;1991年在中国科学院感光化学研究所获得理学博士学位。曾在日本京都大学、美国伊利诺伊大学香槟分校进行博士后研究工作,中国科学院人才计划入选者。曾任中国科学院光化学重点实验室主任,分子反应动力学重点实验室主任、中国科学院化学所副所长;中国化学会秘书长,第九届全国科协委员,亚洲大洋州光化学理事会副理事长;法国上阿尔萨斯大学高级访问学者;中国科学院大学副校长。现任中国科学院化学研究所二级研究员、中国科学院大学教授;中国化学会理事、光化学专业委员会副主任、高压化学专业委员会主任;中国感光学会光刻材料与技术专业委员会主任;中国光学学会光刻技术专业委员会副主任,亚洲大洋州光化学理事会理事;J. Photochem. Photobiol. A:Chem. 助理主编,J. Photochem. Photobiol. C 编委、《化学通报》、《高压物理学报》编委。承担了包括科技部863项目、02专项项目、国家重点研发计划项目;国家自然科学基金委重点基金、国家重大科研仪器研制项目;中国科学院科技专项等重要研究任务。在光功能化合物和功能材料的分子设计、材料合成、性能及其作用机理方面开展研究工作,在包括PRL、Angew. Chem. Int. Ed.、JACS、Nature Comm.等学术刊物上发表研究论文300余篇;申请发明专利74项,已经获得授权发明专利51项。

通讯作者
陈金平,分别在山东大学和中国科学院理化技术研究所获得学士和博士学位,2007年受日本学术振兴会的资助,在日本京都大学从事博士后研究工作。现任中国科学院理化技术研究所研究员。入选2009年度北京市科技新星,首届中国科学院青年创新促进会会员(2011年),优秀会员(2015年),理化所优秀员工(2021年)。主要从事高档光刻胶的研发与产业化工作,主持或参与02重大专项、国家自然科学基金重大/面上项目、中国科学院科技专项等项目,已发表学术论文100余篇,申请光刻胶发明专利54项(授权23项)。

第一作者
彭蓉蓉,2020年获四川大学工学学士学位,2020年—2025年于中国科学院理化技术研究所攻读理学博士学位(硕博连读)。攻读博士期间导师为陈金平研究员与李嫕研究员,研究方向为光化学与光功能材料。
ICM相关文章
1. 碳分子筛孔结构精准调控实现含氟特气中结构相似杂质的定向脱除
Fine-tuned ultramicroporous carbon materials via CO2 activation for molecular sieving of fluorinated propylene and propane, https://doi.org/10.1039/D5IM00079C
2. 磺酸型聚合物:解锁光刻胶树脂单体痕量络合态Cr³⁺脱除的“破络-吸附”密钥
Engineering sulfonated polymers for the removal of ultra-trace complexed Cr(III) in tris(2-carboxyethyl) isocyanurate photoresist resin monomers, https://doi.org/10.1039/D5IM00057B
Synthesis and properties of a novel perfluorinated polyimide with high toughness, low dielectric constant and low dissipation factor, https://doi.org/10.1039/D5IM00048C
4. 破解电子材料双重密码:分子拓扑构筑超低介电与低热膨胀新体系
Molecular topology-driven benzocyclobutene-based ultralow dielectrics with copper-matched low thermal expansion,https://doi.org/10.1039/D5IM00051C
Silane production from the dichlorosilane by-product of the Siemens process: a comparative study with the trichlorosilane route, https://doi.org/10.1039/D5IM00040H
期刊简介
Industrial Chemistry & Materials (ICM) 目前已被ESCI、EI、CSCD、美国化学文摘(CA)、DOAJ等数据库检索,首个影响因子11.9,位列Q1区,入选2024年中国科技期刊卓越行动计划高起点新刊项目。是中国科学院主管,中国科学院过程工程研究所主办,英国皇家化学会(RSC)全球出版发行的Open Access英文期刊,由中国科学院过程工程研究所张锁江院士担任主编。ICM 以化学、化工、材料为学科基础,以交叉为特色,以应用为导向,重点关注工业过程中化学问题、高端材料创制中过程科学的国际前沿和重大技术突破,目前对读者作者双向免费。欢迎广大科研工作者积极投稿、阅读和分享!
期刊网站:https://www.rsc.org/journals-books-databases/about-journals/industrial-chemistry-materials
投稿网址:https://mc.manuscriptcentral.com/icmat
联系邮箱:icm@rsc.org; icm@ipe.ac.cn
联系电话:010-82612330
微信公众号:ICM工业化学与材料
Twitter & Facebook:@IndChemMater
LinkedIn: https://www.linkedin.com/company/industial-chemistry-materials/
Blog: https://blogs.rsc.org/im/?doing_wp_cron=1713430605.5967619419097900390625

转载本文请联系原作者获取授权,同时请注明本文来自孔景科学网博客。
链接地址:https://wap.sciencenet.cn/blog-3388879-1497350.html?mobile=1
收藏

