博文
CMP中的氧化铈浆料:Zeta和硅酸盐吸附试验
||

为了进一步阐明SiO2基衬底的化学机械抛光的机理,通过吸附和Zeta电位测试实验来研究氧化铈颗粒与硅酸盐离子的相互作用。实验结果表明:当CeO2分散液中存在硅酸盐离子时,氧化铈粒子的zeta电位由正变为负,进一步,随着硅酸盐离子含量的增加,氧化铈颗粒的等电点IEP向更低的pH值移动。此外,硅酸盐离子在氧化铈颗粒表面的吸附密度随着分散液中硅酸盐离子含量的增加而增加。另一方面,随着pH的增加,硅酸盐的吸附在pH=9左右达到最大值,但随着pH值进一步增加,硅酸盐离子的吸附密度开始迅速下降。通过溶解的硅酸盐种类的溶液化学性质、氧化铈表面的质子化/去质子化以及伴随的氧化铈颗粒与SiO2衬底表面络合反应,对吸附和zeta电位结果进行合理解释。这些实验结果表明,二氧化铈颗粒与硅酸盐离子之间存在很强的相互作用。在CMP过程中,硅酸盐离子在铈上的吸附可能直接参与了硅基材料的去除机理
化学机械抛光通常发生在水相环境下,在水相环境下金属氧化物会发生质子化和去质子化行为,这取决于颗粒的等电点和所处溶液pH值。具体可参照下式,其中-M-OH是中性羟基,而-M-OH2+和-M-O-个分别是质子化和去质子化的表面基团。因此,可以联想到在实际的化学机械抛光过程中(pH=7-10),氧化铈磨料和SiO2衬底表面发生pH依赖的电荷变化。一般而言,氧化铈颗粒的等电点(pHpzc ≈ 6.75-7.6),氧化硅颗粒的等电点(pHpzc ≈ 1.5 to 2.8),在玻璃的抛光过程中,二氧化硅玻璃表面的物质的去除是由于借助表面化学键形成,石英玻璃在氧化铈颗粒表面的临时附着(-Ce-OH+-Si-O- ⇌ -Si-O-Ce- + OH-)
-M-OH +H+⇌-M-OH2+ (pH < point of zero charge, pHpzc)
-M-OH ⇌-M-O-+H+ (pH > point of zero charge, pHpzc)
Osseo-Asare和Khan通过zeta电位测量研究了钨酸盐离子与氧化铝之间的相互作用。实验结果表明:氧化铝颗粒对钨酸盐离子的强吸附表明在钨CMP过程中吸附行为对钨材料的去除起重要作用。受此启发,计划通过Zeta电位测试和吸附实验,模拟CMP过程,来阐明在实际的CMP过程中下氧化铈/二氧化硅相互作用的本质。具体了测定了二氧化铈悬浮液的zeta电位随时间、pH和硅酸盐浓度的变化以及氧化铈颗粒对硅酸盐离子的吸附与pH和硅酸盐浓度的关系。
Zeta电位测试:氧化铈悬浮液的配置将一定量的氧化铈和偏硅酸钠(Na2SiO3•9H2O)分散在去离子水中(0.1 g/L ceria);二氧化硅分散液的配置:将一定量的二氧化硅分散在去离子水中。在恒定的离子强度下(10-2 M NaNO3),测定了pH 2-12范围内上述氧化铈和二氧化硅分散液的Zeta电位,通过加入少量稀硝酸和氢氧化钠来调节pH值。
吸附实验:在容量瓶中配置了不同浓度硅酸盐溶液(5*10-4 -3.6*10-3 M),然后转移到125 mL聚乙烯瓶中,以避免玻璃器皿中的硅酸盐离子溶解,利用稀硝酸和稀氢氧化钠溶液调节硅酸盐溶液的pH=2-12,将一定量的氧化铈颗粒加入上述硅酸盐溶液中,含量为16.3 g/L。悬浮液在室温下平衡24小时,并用磁力搅拌器不断。搅拌结束后,将悬浮液转移到聚丙烯注射器中,并通过0.2 mm的膜过滤器过滤(Nalgene,无表面活性剂醋酸纤维素,25mm直径),然后用电感耦合等离子体发射分光光度法测量平衡后溶液中游离的硅酸盐离子含量,最终通过物料守恒,通过平衡时硅酸盐在氧化铈颗粒表面的吸附密度。
下图为二氧化铈分散液在含有硅酸盐离子和不含硅酸盐离子时,氧化铈颗粒Zate电位随时间的变化,其中当不含有硅酸盐离子时,颗粒的zeta电位随时间的延长缓慢增加的原因是在pH值低于6时,氧化铈表面发生水解获得了正电荷(-Ce-OH +H+⇌-Ce-OH2+ (pH < point of zero charge, pHpzc),当向体系中加入硅酸盐离子时,电势迅速从正极变为负极。最后,含硅酸盐体系的曲线在-8 mV左右达到平稳。颗粒表面电荷的变化表明带负电荷的硅酸盐离子会特异性地吸附在二氧化铈表面。

![]()
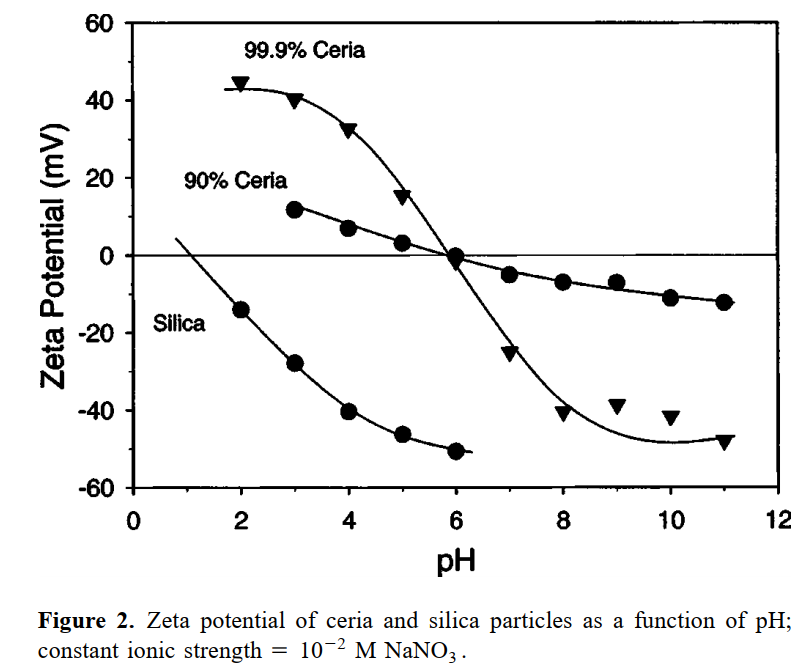
在铈分散体中加入不同浓度的硅酸盐离子,研究了铈颗粒与硅酸盐离子的相互作用。随着Na2SiO3浓度的增加,氧化铈的zeta电位变得不那么正,且等电点移动到较低的pH值。此外,在硅酸盐离子存在下,氧化铈粒子的zeta电位倾向于表现出与二氧化硅相似的趋势,99.9%氧化铈颗粒的zeta电位也表现出类似的行为。氧化铈颗粒zeta电位符号的反转和IEP值的移动说明:硅酸盐离子可以特异性地吸附在二氧化铈颗粒表面,且硅酸盐离子的吸附引起氧化铈颗粒的等电点向酸性区域的移动
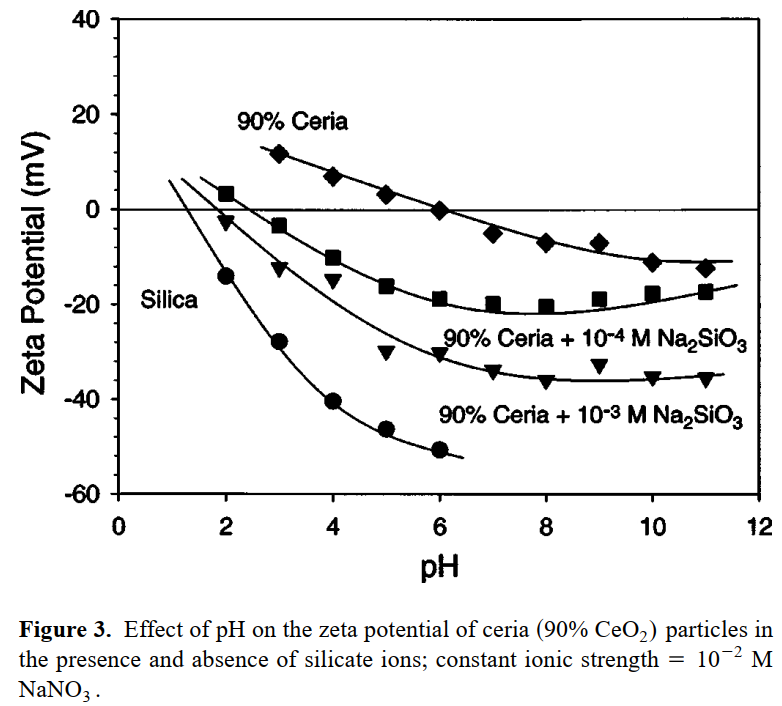
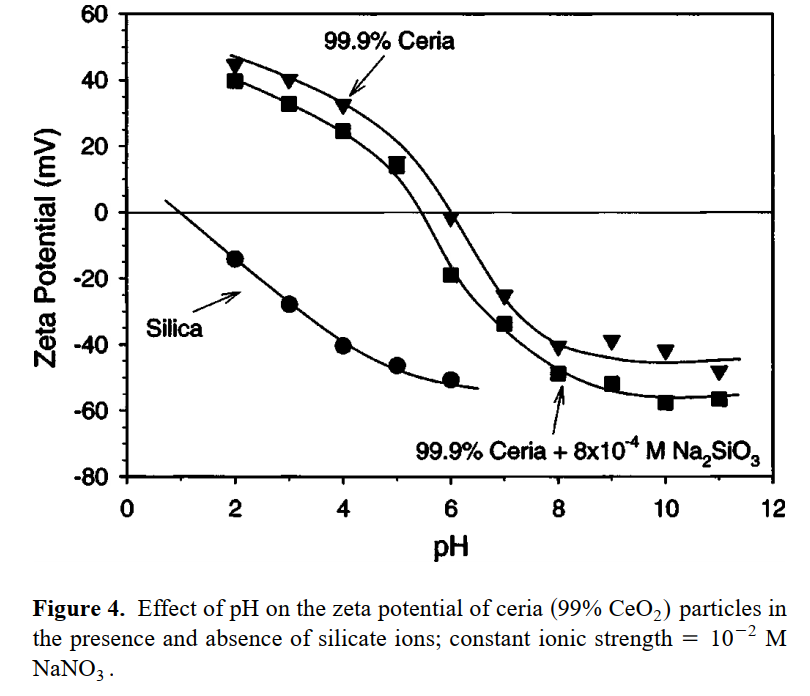
pH和硅酸盐离子浓度对氧化铈颗粒吸附硅酸盐的影响。由下图可知:硅酸盐吸收量随着水相中硅酸盐离子浓度的增加而增加。另一方面,随着pH的增加,硅酸盐吸附曲线也在逐渐增加,且在pH=9左右,硅酸盐的吸附容量达到最大值,随后随着pH的进一步增大而开始减小,该实验结果可进一步推广至CMP后清洗阶段,即将pH值提高到9以上,可以实现硅酸盐离子的解吸,通过调整溶液在这些区域的pH值,可以减少残留颗粒的粘连(如下图所示)。在实际清洗过程的pH值一般在pH 6至8范围内,因为二氧化硅的溶解在pH=9以上会大大增加。结合Zeta电位测试结果,当达到硅酸盐离子最大吸附容量pH=9,氧化铈和二氧化硅的颗粒均带负电,即使这样,硅酸盐离子依然可以在氧化铈颗粒表面发生吸附,这种类型的吸附是硅酸盐离子是化学键合,或化学吸附,附着在二氧化铈颗粒表面。
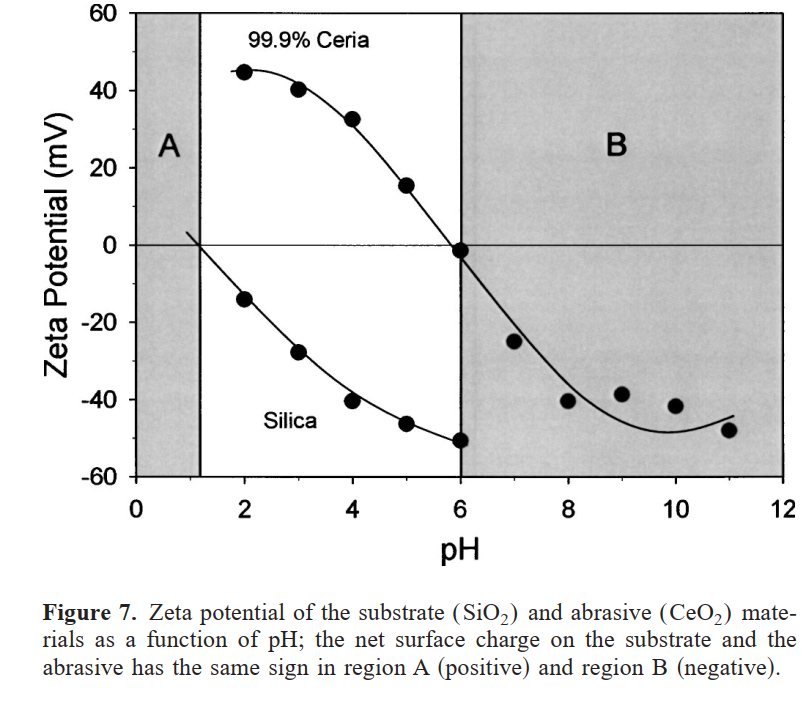
关于硅酸盐离子在氧化铈颗粒表面吸附时,吸附物种的主要存在形式存在争议,Sigg和Stumm认为硅酸Si(OH)4(aq)是吸附金属氧化物的主要物质。然而,如下图所示:不同pH条件下,硅酸盐物种的存在形式不一样,当硅酸盐溶液的pH<9时,溶液中的主要物质是硅酸Si(OH)4(aq),但它是一种中性物质。如果硅酸Si(OH)4是氧化铈颗粒表面的主要吸附物种,那么在酸性区域吸附量会很高。另一方面,由Si(OH)4去质子化产生的SiO(OH)3-阴离子是主要的氧化铈颗粒表面的吸附物种Si(OH)4(aq)⇌ SiO(OH)3 -+ H+ log K=-9.46),水溶液中SiO(OH)3-的浓度随pH变化关系和吸附曲线很类似,且在SiO(OH)3-阴离子的存在下,氧化铈的Zeta电位变得更负,当pH>9时,由于电荷间的排次作用,吸附密度开始显著下降。
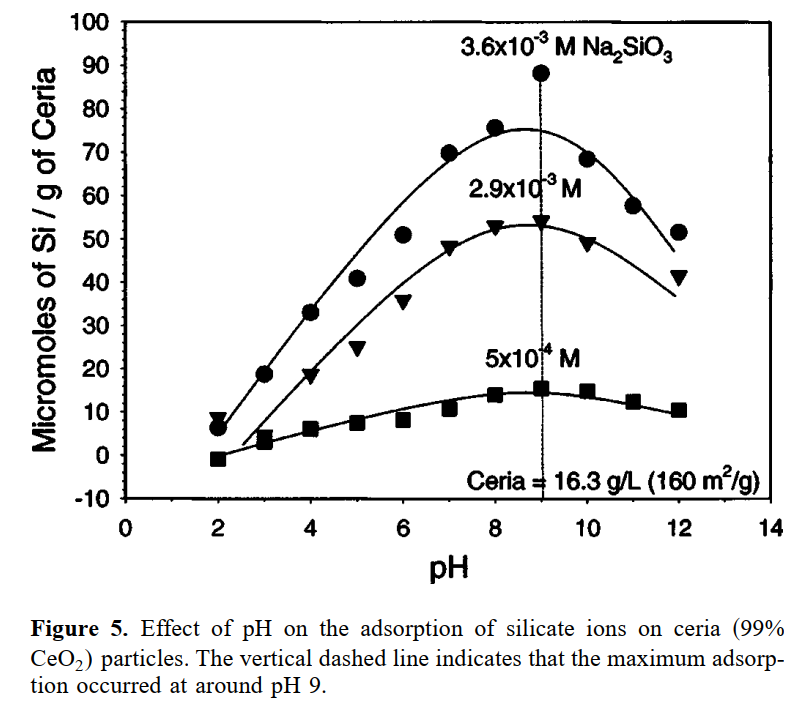
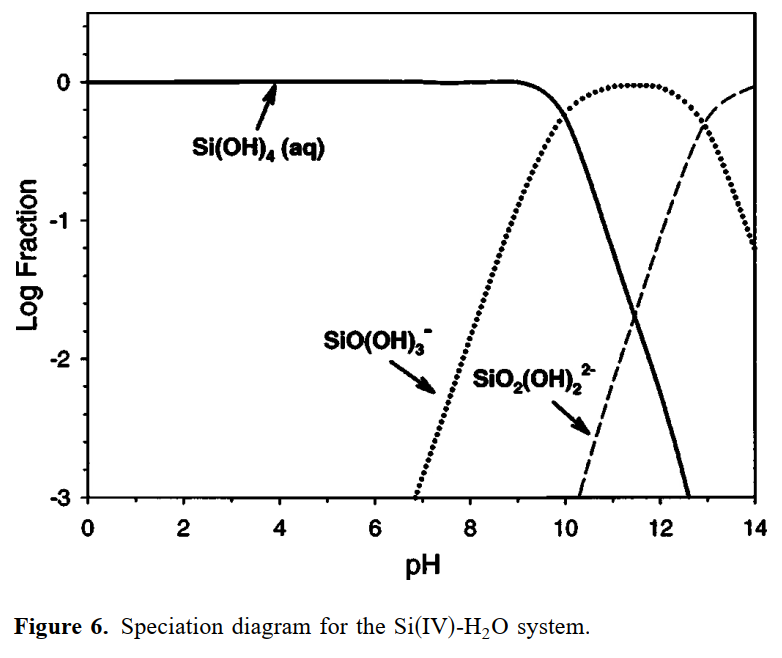
当水相pH值低于氧化铈颗粒的等电点时pH<6,氧化铈表面带正电。因此,带正电的氧化铈表面与硅酸盐阴离子(SiO(OH)3-)之间存在静电吸引作用:-Ce-OH2++ (HO)SiO(OH)2- ⇌ -Ce-O-OSiO(OH)2- + H+。随着pH的增加,促进平衡向右移动,有利于生成更多的-Ce-O-OSiO(OH)2- ,从而增强了硅酸盐的吸附
当水相的pH等于氧化铈颗粒的等电点时pH=6,硅酸盐离子的吸附形式为-Ce-OH+ (HO)SiO(OH)2- ⇌ -Ce-O-OSiO(OH)2- + H2O
在水相pH值高于6时,氧化铈颗粒表面带负电荷,硅酸盐离子的吸收可以按照以下方式进行-Ce-O- +(HO)SiO(OH)2- ⇌ -Ce-O-OSiO(OH)2- + OH-。然而,随着溶液pH值的增加,氧化铈表面的负电荷增加,导致带负电荷的氧化铈表面与硅酸盐离子之间产生排斥,吸附量开始减少。
SiO2的CMP的机理:氧化铈颗粒对硅酸盐离子的吸附实验表明,吸附可能参与了CMP过程中二氧化硅的去除。SiO2(s)+ H2O⇌ Ce(OH)4 (aq),然后是Si(OH)4(aq)⇌ SiO(OH)3 -+ H+,-Ce-OH2++ (HO)SiO(OH)2- ⇌ -Ce-O-OSiO(OH)2- + H+ or -Ce-OH+ (HO)SiO(OH)2- ⇌ -Ce-O-OSiO(OH)2- + H2O or -Ce-O- +(HO)SiO(OH)2- ⇌ -Ce-O-OSiO(OH)2- + OH-
https://wap.sciencenet.cn/blog-3400811-1426539.html
上一篇:水热合成的影响因素-pH值/水热处理是一种奥斯特瓦尔德成熟过程
下一篇:沉淀法合成纳米氧化铈颗粒:反应气氛和反应温度的影响